2023年全球手机市场持续低迷,折叠屏手机异军突起, 是目前手机市场里唯一保持上升趋势的细分市场。据 Counterpoint全球折叠屏手机出货量将从...
2024-03-05 24 电子行业报告
功能整合形成系统级芯片 SoC 和系统级封装 SiP 两大主流。两者目标都是在同一产品中实现多种 系统功能的高度整合,其中 SoC 从设计和制造工艺的角度,借助传统摩尔定律驱动下的半导体芯 片制程工艺,将一个系统所需功能组件整合到一块芯片,而 SiP 则从封装和组装的角度,借助后段 先进封装和高精度 SMT 工艺,将不同集成电路工艺制造的若干裸芯片和微型无源器件集成到同一 个小型基板,并形成具有系统功能的高性能微型组件。 受限于摩尔定律的极限,单位面积可集成的元件数量越来越接近物理极限。而 SiP 封装技术能实 现更高的集成度,组合的系统具有更优的性能,是超越摩尔定律的必然选择路径。相比 SOC,(1)SiP 技术集成度更高,但研发周期反而更短。SiP 技术能减少芯片的重复封装, 降低布局与排线难度,缩短研发周期。采用芯片堆叠的 3D SiP 封装,能降低 PCB 板的使用量, 节省内部空间。例如:iPhone7 PLUS 中采用了约 15 处不同类型的 SiP 工艺,为手机内部节省空 间。SiP 工艺适用于更新周期短的通讯及消费级产品市场。(2)SiP 能解决异质(Si,GaAs)集成问题。手机射频系统的不同零部件往往采用不同材料和工艺,如:硅,硅锗(SiGe)和砷化镓(GaAs) 以及其它无源元件。目前的技术还不能将这些不同工艺技术制造的零部件制作在一块硅单晶芯片 上。但是采用 SiP 工艺却可以应用表面贴装技术 SMT 集成硅和砷化镓裸芯片,还可以采用嵌入式 无源元件,非常经济有效地制成高性能 RF 系统。光电器件、MEMS 等特殊工艺器件的微小化也将 大量应用 SiP 工艺。
在过去数十年,电子制造行业形成了晶圆制造、封测和系统组装三个泾渭分明的环节,代表厂商分 别是台积电、日月光和鸿海,他们的制造精度分别是纳米、微米和毫米级别。随着消费电子产品集 成度的提升,部分模组、甚至系统的组装的精度要求逼近微米级别,跟封测环节在工艺上产生了重 叠,业务上产生了竞争或协同。具体来看,SiP 工艺融合了传统封测中的 molding、singulation 制程和传统系统组装的 SMT 和系 统测试制程。5G 商用日益临近,世界范围内主流国家的运营商都已明确时间节点。截至 2019 年 10 月 16 日, 华为已经和全球领先运营商签定 60 多个 5G 商用合同,40 多万个 5G Massive MIMO AAU 发往 世界各地。而从世界范围来看,主流国家的电信运营商大多计划在 2019-2020 年期间开始部署 5G 网络并逐步推出商用服务,国内也已于 2019 年 Q3 顺利完成 5G 技术研发第三阶段测试,并正式 进入 5G 产品研发试验阶段,国内运营商也已经在 2019 年初正式启动 5G 规模组网试点工程招标。
由于历史原因,3GHz 以下可用于公众移动通信的低频段已基本被前几代通信网络瓜分完毕,且频 段分散,无法提供 5G 所需的连续大带宽,因而 5G 必然向更高的工作频段延伸。目前世界范围内 对于 5G 的频谱已基本达成共识,3~6 GHz 中频段将成为 5G 的核心工作频段,主要用于解决广域 无缝覆盖问题,6GHz 以上高频段主要用于局部补充,在信道条件较好的情况下为热点区域用户提 供超高数据传输服务,例如对于 26GHz、28GHz、39GHz 毫米波应用也逐渐趋向共识,5G 的频 段分为 Sub-6 和毫米波两个部分。

标签: 电子行业报告
相关文章

2023年全球手机市场持续低迷,折叠屏手机异军突起, 是目前手机市场里唯一保持上升趋势的细分市场。据 Counterpoint全球折叠屏手机出货量将从...
2024-03-05 24 电子行业报告

硬件端:Vision Pro顶级配置实现性能突破。2016虚拟现实元年以来,硬件端持续迭代,2023年Meta发布其首款消费级MR一体机, 2024年...
2024-03-05 42 电子行业报告

参考全球 ODM 龙头厂商闻泰科技建设的年产 3000 万台、年产 1500 万台智能手机生产线 中设备投资规模,可大概推算出 2022 年全球 12...
2024-03-05 26 电子行业报告

2023年我国工业互联网核心产业规模达1.4万亿元。我国工业互联网自2012年起步谋划,经历探索和快速推进期,目前已进入规 模发展期。据工信部,202...
2024-03-04 32 电子行业报告
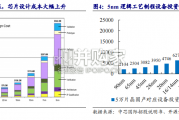
先进封装为后摩尔时代延续芯片性能提升的重要手段之一。摩尔定律指集成电 路上容纳的晶体管数目约每 18 个月便会增加一倍,但随着晶体管特征尺寸缩小到 1...
2024-03-04 41 电子行业报告

无线短距通信技术一般指作用距离在毫 米级到千米级的,局部范围内的无线通信应 用。其中,WiFi和蓝牙是两大主流的技术标 准,分别适用于高速率、大传输、...
2024-03-04 44 电子行业报告
最新留言