2023年全球手机市场持续低迷,折叠屏手机异军突起, 是目前手机市场里唯一保持上升趋势的细分市场。据 Counterpoint全球折叠屏手机出货量将从...
2024-03-05 24 电子行业报告
传统意义的芯片封装一般指安放集成电路芯片所用的封装壳体,它同时可 包含将晶圆切片与不同类型的芯片管脚架及封装材料形成不同外形的封 装体的过程。从物理层面看,它的基本作用为:为集成电路芯片提供稳定 的安放环境,保护芯片不受外部恶劣条件(例如灰尘,水气)的影响。从 电性层面看,芯片封装同时也是芯片与外界电路进行信息交互的链路,它 需要在芯片与外界电路间建立低噪声、低延迟的信号回路。然而不论封装技术如何发展,归根到底,芯片封装技术都是采用某种连接 方式把晶圆切片上的管脚与引线框架以及封装壳或者封装基板上的管脚 相连构成芯片。而封装的本质就是规避外界负面因素对芯片内部电路的影 响,同时将芯片与外部电路连接,当然也同样为了使芯片易于使用和运输。 芯片封装技术越来越先进,管角间距越来越小,管脚密度却越来越高,芯 片封装对温度变化的耐受性越来越好,可靠性越来越高。另外一个重要的 指标就是看,芯片与封装面积的比例。 此外,封装技术中的一个主要问题是芯片占用面积,即芯片占用的印刷电 路板(PCB)的面积。从早期的 DIP 封装,当前主流的 CSP 封装,芯片与封 装的面积比可达 1:1.14,已经十分接近 1:1 的理想值。而更先进 MCM 到 SIP 封装,从平面堆叠到垂直堆叠,芯片与封装的面积相同的情况下进一 步提高性能。
在此背景下,焊球阵列封装(BGA)获得迅猛发展,并成为主流产品。BGA 按封装基板不同可分为塑料焊球阵列封装(PBGA),陶瓷焊球阵列封装 (CBGA),载带焊球阵列封装(TBGA),带散热器焊球阵列封装(EBGA), 以 及倒装芯片焊球阵列封装(FC-BGA)等。 为适应手机、笔记本电脑等便携式电子产品小、轻、薄、低成本等需求, 在 BGA 的基础上又发展了芯片级封装(CSP); CSP 又包括引线框架型 CSP、 柔性插入板 CSP、刚性插入板 CSP、园片级 CSP 等各种形式,目前处于 快速发展阶段。 同时,多芯片组件(MCM)和系统封装(Si P)也在蓬勃发展,这可能孕育 着电子封装的下一场革命性变革。MCM 按照基板材料的不同分为多层陶瓷 基板 MCM(MCM-C)、多层薄膜基板 MCM(MCM-D)、多层印制板 MCM(MCM- L)和厚薄膜混合基板 MCM(MCM-C/D)等多种形式。SIP 是为整机系统小 型化的需要,提高半导体功能和密度而发展起来的。SIP 使用成熟的组装 和互连技术,把各种集成电路如 CMOS 电路、Ga As 电路、Si Ge 电路或 者光电子器件、MEMS 器件以及各类无源元件如电阻、电容、电感等集成到 一个封装体内,实现整机系统的功能。

标签: 电子行业报告
相关文章

2023年全球手机市场持续低迷,折叠屏手机异军突起, 是目前手机市场里唯一保持上升趋势的细分市场。据 Counterpoint全球折叠屏手机出货量将从...
2024-03-05 24 电子行业报告

硬件端:Vision Pro顶级配置实现性能突破。2016虚拟现实元年以来,硬件端持续迭代,2023年Meta发布其首款消费级MR一体机, 2024年...
2024-03-05 42 电子行业报告

参考全球 ODM 龙头厂商闻泰科技建设的年产 3000 万台、年产 1500 万台智能手机生产线 中设备投资规模,可大概推算出 2022 年全球 12...
2024-03-05 26 电子行业报告

2023年我国工业互联网核心产业规模达1.4万亿元。我国工业互联网自2012年起步谋划,经历探索和快速推进期,目前已进入规 模发展期。据工信部,202...
2024-03-04 32 电子行业报告
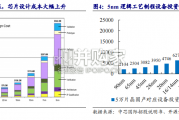
先进封装为后摩尔时代延续芯片性能提升的重要手段之一。摩尔定律指集成电 路上容纳的晶体管数目约每 18 个月便会增加一倍,但随着晶体管特征尺寸缩小到 1...
2024-03-04 41 电子行业报告

无线短距通信技术一般指作用距离在毫 米级到千米级的,局部范围内的无线通信应 用。其中,WiFi和蓝牙是两大主流的技术标 准,分别适用于高速率、大传输、...
2024-03-04 44 电子行业报告
最新留言