PCB行业是全球电子元件细分产业中产值占比最大的产业,随着研发深入和技术不断升级,PCB 产品 逐步向高密度、小孔径、大容量、轻薄化方向发展。据据中商...
2026-03-03 45 电子行业报告
1975s-1995s:Wire Bond时期。引线键合技术,通过金属引线实现芯片与基板的电气连接,成本低廉且工艺成熟,但受限于引线长度和布局方 式,信号传输路径较长,难以满足高性能计算芯片的需求。 1995s-2012s:Flip Chip时期。倒装芯片技术,通过在整个芯片正面布置锡球/铜柱凸块,连接密度提升的同时还缩短了信号传输路径,被广泛 应用于CPU、GPU和高速DRAM芯片的封装,当凸点间距缩小到40μm以下时,传统回流焊工艺会出现翘曲和精度问题。 2012s-2015s:TCB Bonding时期。热压键合技术,通过加热(通常300–400°C)并施加机械压力,促使金属扩散和塑性变形,形成冶金键合。 2015s-2018s:HD Fan Out时期。扇出封装技术,基于重组技术,芯片被切割完毕后,将芯片重新嵌埋到重组载板,封装测试后将重组载板切 割为单颗芯片,芯片外的区域为Fan-Out区域。 2018s-2025s:Hybrid Bonding时期。2D 晶体管缩小的时代日渐放缓,混合键合带来3D新时代。其主要用于实现不同芯片之间的高密度、高性 能互联。技术关键特征是通过直接铜对铜的连接方式取代传统的凸点或焊球(bump)互连,从而能够在极小的空间内实现超精细间距的堆叠和封 装,达到三维集成的目的。

标签: 电子行业报告
相关文章

PCB行业是全球电子元件细分产业中产值占比最大的产业,随着研发深入和技术不断升级,PCB 产品 逐步向高密度、小孔径、大容量、轻薄化方向发展。据据中商...
2026-03-03 45 电子行业报告
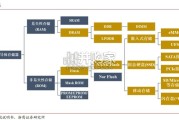
存储芯片是一种用于存储数据和程序的半导体集成电路,是各类电子设备实现数据存储 功能的关键部件。存储产品广泛应用于各种消费电子产品、企业级数据中心、云计...
2026-03-02 53 电子行业报告

中美欧作为全球GDP最高的三大经济体,发电量也位居全球前三,2024年中美欧发电量分别达到10.0/4.4/2.7万亿kwh,分别占全球总发 电量33...
2026-02-28 57 电子行业报告

存储需求从传统的“容量驱动”转变为“容量+带宽+延迟”等性能驱动。过往传统周期,存储 行业主要受下游消费电子换机周期和库存周期约束,行业周期性波动明显...
2026-02-28 36 电子行业报告

技术突破交互革新,终端替代潜力凸显:AI 眼镜正逐步演变为新一代人机 交互的核心载体,行业在 2023 年迎来关键转折,背后是多项核心技术的集中 突破...
2026-02-20 58 电子行业报告

优秀的综合性家电集团:1)治理结构持续优化。海信原为青岛国有控股企 业,2020 年启动混改引入战略投资者后,海信视像、海信家电均变为无实际 控制人状...
2026-02-20 23 电子行业报告
最新留言