数字波束合成芯片(Digital Beamforming IC),即数字波束形成集成电路,是无线通信系统中的重要器件, 用于控制信号的相位和幅度,从而...
2025-09-25 1 电子行业报告
先进封装是“超越摩尔”思路下提升芯片性能的重要路径。封装工艺已实现由 “封”向“构”升级,发展出如 FC、FO、WLCSP、SiP 和 2.5D/3D 等先进封装, 优势明显(性能高、成本低、面积小、周期短等),应用边际不断拓宽。AI 应用 打开 CoWoS 封装成长空间:CoWoS 是台积电开发的 2.5D 封装工艺,在 AI 时代 实现放量。AI 芯片对更强算力和更多内存的需求,驱动 CoWoS-S(硅中介层) 向更大尺寸发展,在此过程中,复杂工艺带来良率挑战,中介层尺寸提升引起成 品率下降。为平衡成本和性能,CoWoS-R 与 CoWoS-L 应运而生,相比而言, CoWoS-L 采用“局部硅互联+RDL”作为中介层,有效规避了大尺寸硅中介层带 来的问题,同时保留了硅中介层的优良特性,或成为未来发展的重点。2024 年 台积电已实现 CoWoS-L 量产,英伟达的 Blackwell 系列 GPU 采用该工艺。在高性能计算、AI/机器学习、数据中心、ADAS、高端消费电子设备等终端的强 势需求下,Yole 预测全球先进封装市场规模将从 2023 年的 378 亿元增加至 2029 年的 695 亿美元。电信与基础设施(包括 AI/HPC)是主要驱动力。 2025 年 Q2,北美云厂资本开支再创历史新高,AI 飞轮效应或已形成。在“算力 即国力”的趋势下,国产算力产业正在跨越式发展。随本土 AI 算力芯片蓬勃发 展,自主可控趋势下高端先进封装迎来发展机会。

标签: 电子行业报告
相关文章

数字波束合成芯片(Digital Beamforming IC),即数字波束形成集成电路,是无线通信系统中的重要器件, 用于控制信号的相位和幅度,从而...
2025-09-25 1 电子行业报告

眼动追踪是一种通过利用传感器,如红外摄像头来捕捉和分析眼 球运动信息(眼球/瞳孔位置、瞳孔变化、虹膜角度、视线轨 迹、角膜反射点),进而通过算法实时测...
2025-09-24 12 电子行业报告

从细分产品增速来看,虽然 2024 年多层板总体产值同比仅增长率在个位数,但 18+层多层板产值和产量分别同比增长了 25.2%和 35.4%,是所有...
2025-09-20 50 电子行业报告
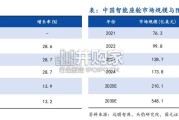
由于舱内与用户接触面大,且交互多,占用时间久,智能座舱是电动智能汽车用户可感知的重要领域。智能座舱市场近年来呈现出快速发展的态势,其规模和增速都十分可...
2025-09-16 52 电子行业报告

显示方案需与光学方案适配,Micro LED 成为光波导终极搭档。目前市场已推出 的显示方案有 LCOS、DLP、LBS、Micro OLED 和 M...
2025-09-04 60 电子行业报告
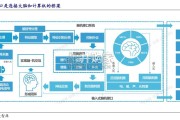
脑机接口下游应用市场潜力大。脑机接口(BCI)是连接大脑与外部设备实现信 息交互的新型技术,广泛应用于疾病预警、诊断、治疗和功能增强等医疗领域及 消费...
2025-08-22 57 电子行业报告
最新留言