2023年全球手机市场持续低迷,折叠屏手机异军突起, 是目前手机市场里唯一保持上升趋势的细分市场。据 Counterpoint全球折叠屏手机出货量将从...
2024-03-05 24 电子行业报告
半导体器件有许多封装形式,按封装的外形、尺寸、结构分类可分为引脚插 入型、表面贴装型和高级封装三类。从 DIP、SOP、QFP、PGA、BGA 到 CSP 再 到 SIP,技术指标一代比一代先进。总体说来,半导体封装经历了三次重大革 新:第一次是在 20 世纪 80 年代从引脚插入式封装到表面贴片封装,它极大 地提高了印刷电路板上的组装密度;第二次是在 20 世纪 90 年代球型矩阵封 装的出现,满足了市场对高引脚的需求,改善了半导体器件的性能;芯片级 封装、系统封装等是现在第三次革新的产物,其目的就是将封装面积减到最 小。
封装主要分为 DIP 双列直插和 SMD 贴片封装两种。从结构方面,封装经历了 最早期的晶体管 TO(如 TO-89、TO92)封装发展到了双列直插封装,随后由 PHILIP 公司开发出了 SOP 小外型封装,以后逐渐派生出 SOJ(J 型引脚小外 形封装)、TSOP(薄小外形封装)、VSOP(甚小外形封装)、SSOP(缩小型 SOP)、 TSSOP(薄的缩小型 SOP)及 SOT(小外形晶体管)、SOIC(小外形集成电路) 等。从材料介质方面,包括金属、陶瓷、塑料、塑料,目前很多高强度工作 条件需求的电路如军工和宇航级别仍有大量的金属封装。
DIP 是英文 Double In-line Package 的缩写,即双列直插式封装。插装型封 装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。DIP 是最普及的 插装型封装,应用范围包括标准逻辑 IC,存贮器 LSI,微机电路等。 从下图可以看到采用此封装的 IC 芯片在双排接脚下,看起来会像条黑色蜈 蚣,让人印象深刻,此封装法为最早采用的 IC 封装技术,具有成本低廉的 优势,适合小型且不需接太多线的芯片。但是,因为大多采用的是塑料,散 热效果较差,无法满足现行高速芯片的要求。因此,使用此封装的,大多是 历久不衰的芯片,如下图中的 OP741,或是对运作速度没那么要求且芯片较 小、接孔较少的 IC 芯片。
PLCC 是英文 Plastic Leaded Chip Carrier 的缩写,即塑封 J 引线芯片封 装。PLCC 封装方式,外形呈正方形,32 脚封装,四周都有管脚,外形尺寸比 DIP 封装小得多。PLCC 封装适合用 SMT 表面安装技术在 PCB 上安装布线,具 有外形尺寸小、可靠性高的优点。

标签: 电子行业报告
相关文章

2023年全球手机市场持续低迷,折叠屏手机异军突起, 是目前手机市场里唯一保持上升趋势的细分市场。据 Counterpoint全球折叠屏手机出货量将从...
2024-03-05 24 电子行业报告

硬件端:Vision Pro顶级配置实现性能突破。2016虚拟现实元年以来,硬件端持续迭代,2023年Meta发布其首款消费级MR一体机, 2024年...
2024-03-05 42 电子行业报告

参考全球 ODM 龙头厂商闻泰科技建设的年产 3000 万台、年产 1500 万台智能手机生产线 中设备投资规模,可大概推算出 2022 年全球 12...
2024-03-05 26 电子行业报告

2023年我国工业互联网核心产业规模达1.4万亿元。我国工业互联网自2012年起步谋划,经历探索和快速推进期,目前已进入规 模发展期。据工信部,202...
2024-03-04 32 电子行业报告
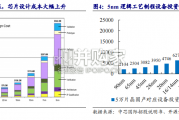
先进封装为后摩尔时代延续芯片性能提升的重要手段之一。摩尔定律指集成电 路上容纳的晶体管数目约每 18 个月便会增加一倍,但随着晶体管特征尺寸缩小到 1...
2024-03-04 41 电子行业报告

无线短距通信技术一般指作用距离在毫 米级到千米级的,局部范围内的无线通信应 用。其中,WiFi和蓝牙是两大主流的技术标 准,分别适用于高速率、大传输、...
2024-03-04 44 电子行业报告
最新留言