2023年全球手机市场持续低迷,折叠屏手机异军突起, 是目前手机市场里唯一保持上升趋势的细分市场。据 Counterpoint全球折叠屏手机出货量将从...
2024-03-05 24 电子行业报告
“计算光刻”是利用计算机建模、仿真和数据分析等手段,来预测、校正、优化和验证光刻工艺在一系列图 案、工艺和系统条件下的成像性能。 计算光刻通常包括光学邻近效应修正(OPC)、光源-掩膜协同优化技术(SMO)、多重图形技术(MPT)、 反演光刻技术(ILT)等四大技术。随着线宽不断微缩,计算光刻软件的需求日益增加。 1、 光学邻近效应修正(OPC) 光学邻近校正(OPC)是一种光刻增强技术,主要在半导体器件的生产过程中使用,目的是为了保证生产过 程中设计的图形的边缘得到完整的刻蚀。这些投影图像因光学衍射而失真如果得不到纠正,可能大大改 变生产出来的电路的电气性能。光学邻近校正通过移动掩膜版上图形的边缘或添加额外的多边形来纠正 这些错误。根据宽度和间距约束(即基于规则的 OPC),或者是通过使用紧凑的模型动态仿真(即基于 模型的 OPC)的结果预先计算出一个查找表,根据这个查找表来决定怎样移动图案的边缘,找到最好的 解决方案。OPC的目标是尽可能的使硅片上生产出的电路与原始的电路一致。 一般来说,当晶圆上的线宽小于曝光波长时,必须对掩膜上的图形做邻近效应修正。例如,使用 248nm波 长光刻机,当图形线宽<250nm 时,必须使用简单的修正;当线宽<180nm 时,则需要非常复杂的修正。使 用 193nm波长光刻机,当最小线宽<130nm时,就必须做图形修正。
光源—掩膜协同优化(Source Mask Optimization, SMO)仿真计算的基本原理与基于模型的邻近效应修正类似。光 源—掩膜协同优化计算出的结果,不仅包含一个像素化的光源,而且包括对输入设计做的邻近效应修正。 由于光照参数和掩膜上的图形可以同时变化,优化计算的结果可能不是唯一。 SMO技术是 14纳米及以下技术节点必不可少的一项分辨率增强技术,针对特定层的设计规则、掩膜结构、 光刻胶层属性和结构等,根据光学模型对光源形状、强度分布和掩膜形状进行同时优化,以获得具有最 大光刻工艺窗口的定制型光源和修正后的掩膜形状。
反演光刻技术,即将光学邻近效应校正(OPC)或光源-掩膜交互优化(SMO)的过程看作逆向处理的问题, 将光刻后的目标图形设为理想的成像结果,根据已知成像结果,根据成像系统空间像的变换模型,反演 计算出掩膜图像。 反演光刻技术非常复杂,特别是对整个芯片而言计算量很大。目前普遍的做法是先使用通常的模型修正 (OPC+SRAF)来完成掩膜数据的处理,然后找出其中不符合要求的部分。把这些“坏点”截取出来,局部做 ILT处理,得到最佳的修正。最后再把经 ILT处理后的部分贴回到数据中去。这种局部的 ILT处理,可以节 省大量的计算时间。

标签: 电子行业报告
相关文章

2023年全球手机市场持续低迷,折叠屏手机异军突起, 是目前手机市场里唯一保持上升趋势的细分市场。据 Counterpoint全球折叠屏手机出货量将从...
2024-03-05 24 电子行业报告

硬件端:Vision Pro顶级配置实现性能突破。2016虚拟现实元年以来,硬件端持续迭代,2023年Meta发布其首款消费级MR一体机, 2024年...
2024-03-05 42 电子行业报告

参考全球 ODM 龙头厂商闻泰科技建设的年产 3000 万台、年产 1500 万台智能手机生产线 中设备投资规模,可大概推算出 2022 年全球 12...
2024-03-05 26 电子行业报告

2023年我国工业互联网核心产业规模达1.4万亿元。我国工业互联网自2012年起步谋划,经历探索和快速推进期,目前已进入规 模发展期。据工信部,202...
2024-03-04 32 电子行业报告
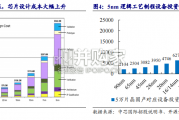
先进封装为后摩尔时代延续芯片性能提升的重要手段之一。摩尔定律指集成电 路上容纳的晶体管数目约每 18 个月便会增加一倍,但随着晶体管特征尺寸缩小到 1...
2024-03-04 41 电子行业报告

无线短距通信技术一般指作用距离在毫 米级到千米级的,局部范围内的无线通信应 用。其中,WiFi和蓝牙是两大主流的技术标 准,分别适用于高速率、大传输、...
2024-03-04 44 电子行业报告
最新留言