2023年全球手机市场持续低迷,折叠屏手机异军突起, 是目前手机市场里唯一保持上升趋势的细分市场。据 Counterpoint全球折叠屏手机出货量将从...
2024-03-05 24 电子行业报告
晶圆在封装前和封装过程中需进行多次多种测试,如封装前的晶圆测试(WAT 测试)、在封测过程中需进行 CP 测试、FT 测试等,所涉及设备包括探针探、测 试机、分选机等,该部分测试设备我们在此前专题报告《检测设备系列之二:半 导体测试设备——进口替代正当时-20200301》中已进行详细论述和市场规模测算, 在此不再赘述,下文对封装环节具体流程和对应设备进行分析和测算。 2.1.封装工艺流程——多环节、高要求 IC 封测可以分为前段和后段工艺,具体加工环节包括磨片、划片、装片、键 合、塑封、电镀、切筋/打弯、打印、测试、包装、仓检、出货等环节,完成从晶 圆到芯片出厂的过程。在 IC 封装前段工艺中,除光学检测外,主要包括磨片、晶圆切割、引线键合 等,对应的设备有磨片机、切割机、引线键合机等,其中引线键合是封装工艺中 最为关键的一步,利用高纯度的金线、铜线或铝线把 Pad 和 Lead 通过焊接的方 法连接起来,Pad 是芯片上电路的外接点,Lead 是 Lead Frame 上的连接点。
根据 SEMI2018 年报告数据,全球封装设备约为 42 亿美元。另外根据 2018 年 VLSI 数据,半导体设备中,晶圆代工厂设备采购额约占 80%,检测设备约占 8%, 封装设备约占 7%,硅片厂设备等其他约占 5%。假设该占比较稳定,结合 SEMI 最 新数据,2019 年全球半导体制造设备销售额达到 598 亿美元,此前预计 2020 年全 球半导体设备销售额将达到 608 亿美元,据此计算出 2019、2020 年全球封测设备 市场空间约为 41.86、42.56 亿美元。结合二者我们判断全球封测装备市场空间在 40-42 亿美元。 与封装测试流程对应的,整个封装与测试设备包括划片机、引线焊接/键合设 备、贴片机、塑封及切筋设备、电镀设备等,根据 VLSI 2018 年数据,贴片机、 划片机/检测设备、引线焊接设备、塑封/切筋成型设备等占比较大,分别约为 30%、 28%、23%、18%,则按照全球封测设备市场规模 42 亿美元计算,前述设备市场规 模分别为贴片机 12.6 亿美元、划片机/检测设备 11.76 亿美元、引线焊接设备 9.66 亿美元、塑封、切筋成型设备 7.56 亿美元。

标签: 电子行业报告
相关文章

2023年全球手机市场持续低迷,折叠屏手机异军突起, 是目前手机市场里唯一保持上升趋势的细分市场。据 Counterpoint全球折叠屏手机出货量将从...
2024-03-05 24 电子行业报告

硬件端:Vision Pro顶级配置实现性能突破。2016虚拟现实元年以来,硬件端持续迭代,2023年Meta发布其首款消费级MR一体机, 2024年...
2024-03-05 42 电子行业报告

参考全球 ODM 龙头厂商闻泰科技建设的年产 3000 万台、年产 1500 万台智能手机生产线 中设备投资规模,可大概推算出 2022 年全球 12...
2024-03-05 26 电子行业报告

2023年我国工业互联网核心产业规模达1.4万亿元。我国工业互联网自2012年起步谋划,经历探索和快速推进期,目前已进入规 模发展期。据工信部,202...
2024-03-04 32 电子行业报告
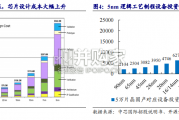
先进封装为后摩尔时代延续芯片性能提升的重要手段之一。摩尔定律指集成电 路上容纳的晶体管数目约每 18 个月便会增加一倍,但随着晶体管特征尺寸缩小到 1...
2024-03-04 41 电子行业报告

无线短距通信技术一般指作用距离在毫 米级到千米级的,局部范围内的无线通信应 用。其中,WiFi和蓝牙是两大主流的技术标 准,分别适用于高速率、大传输、...
2024-03-04 44 电子行业报告
最新留言